正文内容 评论(0)
[以立体空间换取大容量-双面封装与堆叠封装]
倘若单枚芯片无法提供足够的容量,厂商还可以通过双面封装或堆叠封装技术来制造出更大的闪存卡。如在一个封装中整合双枚芯片,容量自然提高了一倍。这种做法目前颇为流行,市面上的大容量闪存卡产品有相当的比例属于该体系。
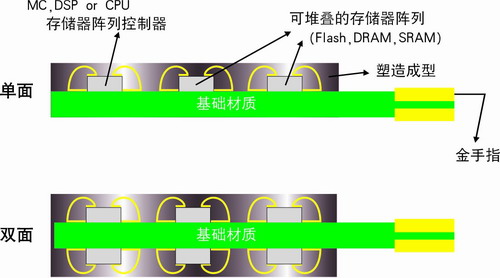
Kingmax公司研发的PIP封装技术是双面封装的代表,PIP将半导体芯片封装与PCB基板组装流程结合起来。传统的存储卡一般为四层结构,从上到下分别为顶盖、写保护开关、PCB电路板和底盖,闪存芯片就直接焊接在PCB电路板的正面。PIP封装对此作了改良,它在PCB电路板的正反面都集成了未封装的闪存颗粒,然后对其作整体式封装,这样闪存卡中的闪存芯片数量就提高一倍,容量当然随之跃升。目前,采用这种技术的只有Kingmax一家企业,虽然他们同样需要向上游企业购买闪存芯片,但封装工序却由Kingmax独自完成。而其他闪存卡厂商都是直接购买封装好的芯片,再将它们集成于电路板之上。如果在电路板的双面都集成芯片,闪存卡就很难保持限定的小体积。
芯片堆叠封装与PIP封装有异曲同工之妙,但实现方式二者完全不同。所谓堆叠是指将从晶圆中切割出来的闪存颗粒叠放在一起,然后作整体封装。从外表来看,它只是一枚普通的单芯片,但其内部却拥有两颗甚至更多的闪存颗粒,实现大容量自然没什么问题。芯片堆叠封装有点3D存储的意味,但我们要明确其堆叠的对象是切割完毕的闪存颗粒,而前面介绍的Reveo 3D存储技术则是将逻辑电路进行堆叠,当它从晶圆上切割出来之后即已拥有超大容量,并不需要再次进行堆叠封装。
堆叠封装的代表厂商是日本东芝公司,在去年4月份它们就向外界推出8GB容量的NAND型闪存,其存储核心其实是由两枚4GB容量的闪存芯片构成。东芝公司还计划制造4枚芯片堆叠封装的闪存产品,可获得16GB的超大容量。换句话说,我们完全不必再担忧闪存容量瓶颈的问题,现在来看是太富余了,厂商应该将重点放在尽快降低主流容量产品的制造成本上面。

